
9800 TC next
Step into the future of advanced packaging with the 9800 TC next, the latest breakthrough in thermo compression bonding technology. Designed to address the increasing demands of chiplet and interposer packages, this state-of-the-art system sets new standards in precision, efficiency, and versatility.
Experience superior bonding with features like an advanced micro-inert chamber for reduced gas consumption, high-resolution vision systems for flawless alignment, and a configurable material feeding system tailored to your specific workflow. Its modular design supports both R&D innovation and high-volume manufacturing, making it the ideal choice for today’s dynamic semiconductor packaging landscape.
Discover how the 9800 TC next can elevate your packaging processes. Contact us today to schedule a live demonstration and see firsthand the future of thermo compression bonding.
More informationThis link leads to an external website.
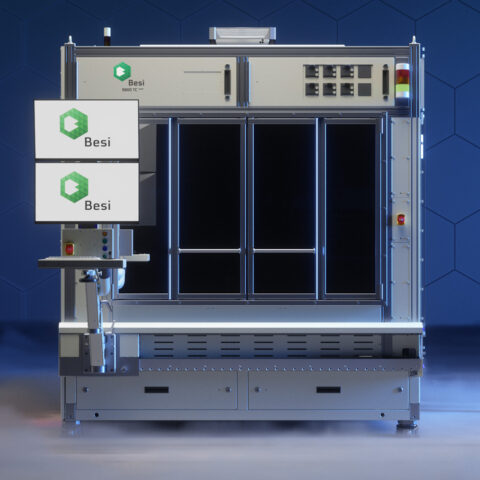

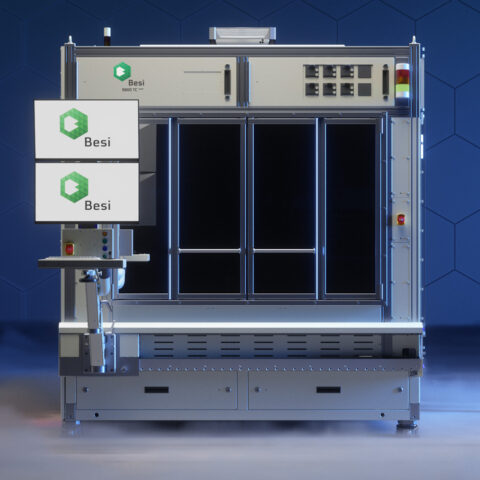
Highlights
Explore all features of the 9800 TC next
Advanced micro-inert chamber
- Optimized for minimal gas consumption, this critical assembly ensures efficient operation and cost savings.
Unmatched accuracy and stability
- Achieve precise bonding with long-term stability, perfect for advancing bump pitch scaling plans.
Powerful bonding capabilities
- The 9800 TC next delivers bonding forces up to 500 N, with an optional upgrade to 1 kN, accommodating a variety of bonding needs.
High-resolution vision systems
- Ensures precise alignment and inspection, crucial for maintaining high quality standards.
Thin die capability
- Expertly handles thin dies, expanding your application possibilities.
Superior process control
- Advanced monitoring functions provide unparalleled control over the bonding process.
Configurable material feeding system
- Offers incredible flexibility, allowing for customized material handling to suit diverse requirements.
Modular design for R&D and high volume
- Available as a dual-module machine for high-volume production or as a single-module system tailored for R&D purposes. The system is upgradeable, adapting seamlessly to evolving use cases.
The 9800 TC next supports a wide range of applications, providing the versatility and performance you need to stay ahead in the rapidly evolving landscape of advanced packaging.
Specifications
The 9800 TC next in numbers
Material handling
| Substrate wafer (through EFEM) | Up to 12” wafer from FOUP (3 x FOUP ports) & quarter panel (300 x 300 mm) |
| Substrate wafer thickness | 0.5 mm to 2.0 mm |
Component supply
| Tray (Jedec) handling | Automatic Tray handling via FOUP |
| T&R cart (roadmap) | 8 mm up to 56 mm feeder |
| T&R cart capacity (roadmap) | Max. 60 x 8 mm feeder (30 pcs. per side) |
| Wafer handling (roadmap) | P&P from taped wafer, waffle pack, gel pack, etc. (up to 15″ frames) via FOUP |
| Die transfer | Non flip & flip |
| Die size | 0.3 x 0.3 mm up to 70 x 70 mm** |
Thermal capabilities @35 mm heater size*
| Substrate wafer temperature | 250°C ± 5°C @ 3s over 300 mm |
| Bond head temperature | 450°C (500°C roadmap) |
| Bond head heating rate | > 400°C/sec from 100°C to 400°C |
| Bond head cooling rate | > 75°C/sec from 350°C to 150°C |
| Bond head thermal control & uniformity | static thermal control: ± 1°C dynamic thermal variation: < 5°C static thermal uniformity: ± 2.5°C |
* (70 mm heater size roadmap, heater sizes up to 100 x 100mm under feasibility review)
P&P capability @35 mm heater size*
| Accuracy X & Y [GoG @150°C] | 0.5 µm @3s |
| Accuracy theta [GoG @150°C] | 1 mdeg @3s |
| WCC (worst case corner) [GoG @150°C] | 0.8 µm @3s |
| Bond head Z control & accuracy | ± 1 µm @3s |
| Bond force | -15 N up to 500 N (1 kN on request) ± 5% of set force @3s (forces > 2 N) ± 5% of set force @3s (forces -15 N to -2 N) ± 0.1 N of set force @3s (forces -2 N to 2 N) |
| Tilt control | < 1 µm (< 2 µm for 70 mm heater size) |
| UPH (bond time 1 sec) | up to 2,500 (product/process dependent) |
* (70 mm heater size roadmap, heater sizes up to 100 x 100mm under feasibility review)
Other
| Inert environment | N2 micro chamber (< 100 ppm O2 @ 75 l/min) / hot pick capability / flux exhaust (optional & on request) |
| Cleanroom class | ISO 5* / Class 100 (FS 209E) |
| Footprint | 6.08 m2 (configuration dependent) |
| Weight | Approx. 7.8 tons (configuration dependent) |
* to be proven in production environment
Software & Automation
- Bond traces and trace viewer
- Bin code matched bonding
- Easy machine calibration via SW assistants
- Inline process monitoring and control
- Main supply surveillance
- Easy product setup via SW assistants
- Parameter provider via SECS/GEM
- E142 map handling
- Full factory automation for Industry 4.0
Video

